
Die Empfindlichkeit gegenüber UV-Strahlung und Strahlung im sichtbaren Wellenlängenbereich wird in nahezu allen Literaturstellen zum Germaniumselenidsystem referiert. Der silberhaltige anorganische Photoresist nach dem Abschnitt ist in einem weiten Spektralbereich empfindlich. Für Photonen- und Teilchenstrahlung mit Energien größer als die der Bandlücke ist die photostimulierte Silberdiffusion der Belichtungsmechanismus. Des weiteren kommt noch die Dotierung aufgrund der thermischen Diffusion von Silber vor. Zur Ionenbestrahlung wurden hier keine Untersuchungen gemacht. Thomas gibt für das GexSe(1-x)-Resistsystem bei zwei x-Werten Empfindlichkeiten gegenüber Edelgas+-Ionen an. Die Elektronenstrahlempfindlichkeit des GexSe(1-x)-Resistsystems ist in mehreren Arbeiten dokumentiert: chopra1, singh2, chen2, polasko1, polasko2. Die Röntgenempfindlichkeit des Germaniumselenidsystems wird in polasko2 nur erwähnt.
Als Lichtquelle für die Belichtungen im optischen Spektralbereich diente eine 75 W Halogen-Kaltlichtspiegel-Lampe. Die Bestrahlungsleistung und damit die Empfindlichkeit konnte bei dieser polychromatischen Bestrahlungen nicht bestimmt werden. Zur relativen Bestrahlungsmessung wurde ein Graukeil hergestellt. Als Substrat diente ein HCM-Glas, das stufenweise mit Chrom bedampft wurde. In einer Aufdampfapparatur der Fa. Edwards wurde bei einem Druck von p< 10-3 Pa Chrom thermisch verdampft. Das Substrat wurde stufenweise von einer Blende freigegeben. Die Blende wurde manuell über eine mechanische Durchführung von außen bewegt. Mittels eines Inficon-Schichtdickenmonitors wurde das Anwachsen der Chromschicht kontrolliert. Der Graukeil wurde mit einer kleinen Blende (1 mm2) und einem Strahlungsmeßgerät kalibriert. Als Strahlungsmeßgerat diente ein Powermeter Modell 212 der Fa. Coherent Radiation mit dem Meßkopf SN 355. Das Meßgerät ist für die Wellenlänge lambda = 633 nm ausgelegt. Die Tabelle gibt die gemessenen Werte wieder. Die optische Dichte ist definiert als der negative dekadische Logarithmus der Transmission. Bei einem Auftrag der verbleibenden Schichtdicke des Resists nach der Entwicklung gegen den dekadischen Logarithmus der Bestrahlungsdosis ergibt sich die charakteristische Kurve des Resists. Aus der Steigung der Kurve folgt direkt der Resistkontrast, dieser ist in der Abbildung vermerkt.
Stufe Transmission optische Dichte 0 1 0 1 0.914 0.039 2 0.683 0.165 3 0.384 0.416 4 0.232 0.634 5 0.143 0.843 6 0.079 1.104 7 0.044 1.357 8 0.018 1.753
Für die Belichtungen wurde ein einfacher Aufbau konstruiert (siehe Abb.. Der Aufbau besteht aus einer Gossen GKL300

Aufbau für Graukeilbelichtungen
Kaltlichtlampe, einem mattierten Glasscheibchen, einem Bogenlampen-Kondensor der Fa. Spindler\Hoyer und einem Halter, auf dem der Graukeil mit den Substraten befestigt wurde. Die Substrate wurden mit Effusionszellen-Verdampfung mit GeS2 beschichtet. Die Schichtdicken des GeS2 variierten von 20 bis 55 nm. Die Schichten wurden standardsensibilisiert, belichtet, desensibilisiert und im Standardentwickler entwickelt. Als Normalentwicklungszeit wurde die Zeit definiert, bei der sich die undotierte, unbelichtete Schicht im Entwickler gelöst hat. Bei der Entwicklung zeigte sich, daß eine Verlängerung der Entwicklungszeit den Kontrast der Normalentwicklung stark eröht. Die Abbildung zeigt die charakteristische Kurve einer 52 nm dicken GeS2-Schicht, die 130 Minuten im Aufbau belichtet wurde.

Charakteristische Entwicklungskurve einer 52 nm dicken GeS2-Schicht
Nach einer Verlängerung der Entwicklungszeit von 40 auf 90 s hatte sich der Kontrast von 1 auf einen Wert von fast 8 erhöht. Die Empfindlichkeit verschlechterte sich dabei um einen Faktor 3.
Zu Belichtungen im ultravioletten Spektralbereich wurde die Struktur der Göttinger Mikrozonenplatte 3 (MZP3) aufbelichtet. Dabei wird mittels frequenzverdoppelter Laserstrahlung die Struktur holographisch belichtet xray2. Die Ausgangswellenlänge des verwendeten Argonionen-Lasers wird bei der Frequenzverdoppelung von 514.5 nm auf 257.25 nm halbiert. Die GeS2-Schichten wurden wieder mit Effusionszellenverdampfung aufgebracht. Die Substrate waren mit einer ca. 80 nm dicken Schicht Chrom bedampfte HCM-Gläser. Die Sulfidschichten hatten eine Dicke von 28 nm und wurden standardsensibilisiert. Belichtungszeiten und damit die Empfindlichkeit sind in der Größenordnung des kommerziellen, organischen Photoresists AZ 1350. Die Abbildung zeigt die ganze Zonenplattenstruktur im Resist. Die Abbildung zeigt die Randbereiche der Zonenplatte mit einer Strukturbreite von 55 nm.
MZP 3-Struktur in 28 nm GeS2 auf Chrom
MZP 3-Randstruktur in 28 nm GeS2 auf Chrom
Mit der MZP 3-Struktur wurden auch Strukturierungsversuche unternommen. Hierzu wurde das folgende Schichtsystem verwendet:
Nach der Desensibilisierung und Entwicklung zeigten sich Haftprobleme der GeS2-Schicht auf dem Polyimid. Die einzelnen Zonen hoben sich teilweise ab. Trotzdem wurde diese Zonenplatten mittels RIE in die Germaniumschicht übertragen. Das Programm dazu sah wie folgt aus:
Im ersten Schritt wird die Polyimid-Schicht durch die Resist-Maskenschicht strukturiert. Im zweiten Schritt wird die Germaniumschicht durch die Polyimid-Maskenschicht geätzt. Das Bild zeigt die Randbereiche der Zonenplatte in Germanium.
Randbereiche einer mittels RIE übertragenen MZP3
Die feinen Strukturen sind deutlich übertragen. Effekte wie das Kräusseln der Zonen aufgrund der Instabilität der Polyimidmaske bzw. der Haftprobleme der Sulfidschicht auf dem Polyimid sind im Rahmen dieser Arbeit dagegen sekundär.
Als weiche Röntgenstrahlung (auch als XUV bezeichnet wegen der Stellung zwischen der UV- und der Röntgenstrahlung (englisch: X-Rays)) bezeichnet man den Wellenlängenbereich von 0.1 bis 10 nm. Als Lichtquelle für die Belichtungen in diesem Bereich diente die Synchrotronstrahlung des Elektronenspeicherringes BESSY (BESSY=Berliner Elektronen Speicherringgesellschaft für Synchrotronstrahlung). Elektronen, die nahezu auf Lichtgeschwindigkeit beschleunigt worden sind, emittieren bei der Ablenkung im Magnetfeld ein breites Spektrum elektromagnetischer Strahlung. Die Stärke des Magnetfeldes und die Elektronenenergie bestimmen die Intensität und Charakteristik dieser Strahlung. Die Forschungseinrichtung Röntgenphysik der Universität Göttingen hat am BESSY-Elektronenspeicherring zwei Synchroton-Strahlrohre zur Verfügung , an denen das Göttinger Raster-Röntgenmikroskop und das Röntgenmikroskop betrieben werden. Zur Belichtung wurden chrombedampfte HCM-Gläser mit GeS2 und GeS1.2(aus der Verdampfung gemäß Abb.). Die Schichtdicke variierte von 20 bis 55 nm. Mittels einer Plattenkamera wurden die beschichteten Substrate in das Röntgenmikroskop eingesetzt. Die Synchrotonstrahlung umfaßt nahezu den gesamten Spektralbereich. Bei der Belichtung im weichen Röntgenbereich müssen zum einen der sichtbare und UV-Bereich der Strahlung und zum anderen der harte Röntgenbereich herausgefiltert werden. Als Filter diente hierbei eine 50 nm dicke Chromschicht auf einer 0.3 µm dicken Polyimidträgerfolie. Eine Reduzierung der harten Strahlung gelingt mit diesem Filter nicht. Die Abbildung zeigt die

Spektrale Leistungsverteilung des BESSY bei der XUV-Belichtung
errechnete spektrale Dosisverteilung am Ort der zu belichtenden Schichten. Die integrierte Gesamtdosisleistung beträgt 86.4 mW/cm2/100 mARingstrom. Mit den Werten für den Ringstrom und der Belichtungszeit läßt sich die Bestrahlungsdosis und damit die Empfindlichkeit des Resistes bestimmen. Die Abbildung zeigt die spektrale Transmission

Spektrale Transmission von 4 nm Ag2S auf 30 nm GeS2 im XUV (nach Henke)
einer mit 4 nm Ag2S beschichteten 30 nm dicken GeS2-Schicht. Das Maximum der BESSY-Strahlung liegt gemäß Abb. bei Wellenlängen kleiner als 1.8 nm. In diesem Bereich beträgt die Absorption der Chalkogenidschicht weniger als 10 %, so daß der größte Teil der Strahlung ungenutzt bleibt. Teilmonochromatische Strahlung im Wellenlängenbereich von 4-8 nm wird effizienter sein, da hier das Maximum der Absorption des Chalkogenides von ca. 40 % erreicht wird. Die angegebenen Empfindlichkeiten würden sich bei einer Belichtung in diesem Bereich um faßt eine Größenordnung erhöhen. Entsprechende Messungen wurden nicht gemacht, da die Belichtungszeiten bei der Verwendung monochromatischer Strahlung aufgrund der starken Schwächung im Monochromator zu lang geworden wären.

XUV-Belichtungskurve einer 47 nm dicken, standardsensibilisierten GeS2-Schicht
Die Abbildung zeigt die XUV-Belichtungskurve einer 47 nm dicken, standardsensibilisierten GeS2-Schicht. Die mit 12 Sekunden normalentwickelte Schicht zeigt schon einen sehr hohen Kontrast von 11, der nach einer verlängerten Entwicklung von 32 Sekunden einen Wert von 20 erreicht. Die Empfindlichkeit des Resists verringert sich hierbei nur um ca. 25 %. Zwischen GeS1.2 (der Wert x=1.2 ergab sich aus der Verdampfung von selbst legiertem Sulfid (siehe Abb.)) und dem GeS2 zeigen sich keine signifikanten Unterschiede. Die Tabelle ((kv) in Spalte 3 bezeichnet Kontrastverstärkung durch verlängertes Entwickeln) zeigt einen Überblick über die experimentellen Ergebnisse.
X-Wert Dicke [nm] Kontrast XUV-Empfindlichkeit [mJ/cm2] 2 19 2 800 1.2 24 16 (kv) 800 2 41 9 1300 2 47 11 900 2 47 20 (kv) 1150 2 52 5 1600 1.2 52 3 1300 1.2 52 25 (kv) 1400 1.2 54 5 1300 1.2 54 13 (kv) 1700
Die Elektronenstrahllithographie ist die derzeit höchstauflösende
Lithographiemethode. Basis dieses Verfahrens ist das
Rasterelektronenmikroskop. Das Rasterelektronenmikroskop erlaubt das
direkte Schreiben von Strukturen mit dem Elektronenstrahl des
Mikroskopes durch die Ansteuerung der Ablenkspulen.
Das Auflösungsvermögen eines elektronenmikroskopischen Systems ist
zum einen durch die Beugung als auch durch Öffnungsfehler begrenzt.
Die Elektronenquelle mit dem Energiespektrum
der austretenden Elektronen führt zu einem chromatischen Fehler des
Systems. Näheres zum Elektronenmikroskop, speziell zum hier
verwandten Raster-Elektronenmikroskop findet sich im Buch von Reimer
und Pfefferkorn.
Der Haupteffekt, der die lithographische Auflösung reduziert, ist die Streuung
der Elektronen im Objektmaterial. Zum
einen reduzieren Sekundärelektronen, die durch rückgestreute
Elektronen oberflächennah ausgelöst werden, die Auflösung. Zum anderen verbreitert sich das Elektronenstrahlprofil
im Material. Dies hat zur Folge, daß rückgestreute Elektronen aus
der Tiefe des Materials zu einer Belichtung des Photoresists in
größerer Umgebung des Elektronenstrahls führen. Dieser
Aufweitungseffekt wird in der englischen Literatur als
Proximity-Effekt bezeichnet.

Monte-Carlo-Simulation zur Aufweitung eines 25 keV Elektronenstrahls in einem Siliziumsubstrat (aus Kyser) (die Tiefenangabe ist in µm)}
Die Abbildung zeigt eine Rechnersimulation zum Aufweitungseffekt aus Kyser. Im Modell wird ein Siliziumsubstrat mit Elektronen mit einer Energie von 25 keV bestrahlt. Es wird deutlich, daß der Strahl bis in Tiefen von 4 µm in das Material eindringt. Rückgestreute Elektronen verursachen einen Streukreis von ca. 3 µm Radius um die Eintrittsstelle an der Materialoberfläche. Dieser Streukreis hat zwar nur eine geringe Intensität, kann jedoch beim Schreiben benachbarter Strukturen zu einer Belichtung des Resists führen aber zumindest den Kontrast herabsetzen. Eine geringere Substratdicke kann dieses Phänomen reduzieren, da die Elektronen an der Rückseite des Substrates austreten und nicht mehr rückgestreut werden können.
Ein apparatives Kernstück des elektronenlithographischen Systems ist das Rasterelektronenmikroskop (REM). Die Abbildung zeigt den schematischen Aufbau des benutzten ISI-DS 130C der Fa. Akashi Seisakusho.

Schema des Rasterelektronenmikroskopes ISI-DS 130C
Als Elektronenquelle dient ein LaB6-Kristall, der direkt elektrisch aufgeheizt wird. Die LaB6-Quelle zeichnet sich durch die geringe Austrittsarbeit für Elektronen aus. Mit dieser kann ein hoher Richtstrahlwert des Elektronenstrahls erzielt werden. Durch eine Anodenhochspannung werden die thermisch aus dem Kristall austretenden Elektronen beschleunigt. Die Elektronen werden durch einen Wehneltzylinder im sog. cross-over gebündelt. Das Cross-over wird mittels eines 5-stufigen magnetischen Linsensystems auf das zu beobachtenden Objekt stark verkleinert abgebildet. Durch das Ablenkspulensystem wird der Elektronenstrahl zeilenweise über das Objekt geführt. Die aus dem Objekt austretenden Sekundärelektronen werden über eine Hochspannung zum Szientillationszähler beschleunigt und detektiert. Das mit den Ablenkspulen synchronisierte Videosignal am Monitor wird mit dem Detektorsignal moduliert. Die Ablenkspulen lassen sich auch extern ansteuern. Als Einheit zur Ansteuerung der Ablenkspulen des lithographisches System dient das System ELPHY III der Fa. Raith. Über einen Personal-Computer lassen sich hiermit nahezu beliebige Strukturen eingeben. Als Auflösungsvermögen des REM wird vom Hersteller ein Wert von 3-5 nm angegeben, was der Fleckgröße des Elektronenstrahls in der Objektebene entspricht.
Zur Bestrahlung mit Elektronen wurden GeS2-Schichten auf chrombedampfte HCM-Gläser aufgebracht. Die Schichten wurden standardsensibilisiert und in die Objektkammer montiert. Mit dem beschriebenen lithographischen System wurden zum einen bei variierten Beschleunigungsspannungen Graustufen in den Resist geschrieben. Die Abbildung zeigt die Aufnahme eines mit 40 keV Elektronen geschriebenen Graukeils in 53 nm normalsensibilisiertem GeS2 bei einer 100 %-Dosis im zentralen Bereich des Graukeils von 2620 µC/cm2. Die Bestrahlungsdosis im Graukeil variiert von 12 bis 800 %.

Elektronenstrahlgraustufen in 53 nm GeS2
Die beschriebenen Resistschichten wurden
standarddesensibilisiert und zuerst normalentwickelt und die
Kontrast- und Empfindlichkeitsmessungen durchgeführt.
Anschließend wurde die Entwicklung fortgesetzt und nach einer
bestimmten Zeit wieder Kontrast- und Empfindlichkeitsmessungen
durchgeführt. Die Messergebnisse sind in Tabelle
aufgeführt.
U0 [kV] Enormal [µC/cm2] gammanormal Everlängert [µC/cm2] gammaverlängert 3 130 0.8 650 5.6 5 300 ca. 1 1100 8.4 10 500 1400 10.3 20 670 3000 10.3 40 2100 ca. 2 6500 3.5
Dabei ist:
Die Normalentwicklung betrug 10 Sekunden, die verlängerte Entwicklung 25 Sekunden im Standardentwickler. Der Kontrast steigt bei verlängerter Entwicklung an, doch fällt die Empfindlichkeit bis auf ein Fünftel des Normalwertes ab. Die Empfindlichkeit ist normal um einen Faktor 3 und verlängert entwickelt um eine Größenordnung geringer als die des organischen Resists PMMA (PMMA = Polymethylmetacrylat). In der Literatur werden die in Tabelle verzeichneten Werte für die Empfindlichkeit des GeSe2-Resistsystems angegeben. Angaben über den Resistkontrast werden dort nicht gemacht.
U0 [kV] E0 [µC/cm2] 3 350 5 400 10 1000 20 3500 30 3600
Zur Bestimmung des Auflösungsvermögens wurden feine Strukturen in den Resist geschrieben. Zwei Resultate sind in den Abbildungen wiedergegeben. Die Abbildung zeigt 40 nm breite Linien, die durch ebenso breite Zwischenräume getrennt sind (L/S (englisch: L/S = line/spaces)) in
40 nm breite L/S in 53 nm GeS2
18 nm breite L/S in 18 nm GeS2
standardsensibilisiertem, 53 nm dicken GeS2-Schichten auf chrombedampften HCM-Gläsern. Die Bestrahlung erfolgte mit einer Elektronenenergie von 20 keV. Die Nasen an den Linien sind ein Artefakt des lithographischen Systems, die später ausgemerzt werden konnten. Die Abbildung zeigt 18 nm L/S in standardsensibilisiertem, 18 nm dickem GeS2 auf chrombeschichteten HCM-Gläsern, die mit 20 keV beschrieben wurden. Trotz des massiven Substrates und des dadurch zu erwartenden starken proximity-Effektes konnten diese feinen Strukturen geschrieben werden.
Nach der Entwicklung verbleibt auf dem zu strukturierenden Substrat eine silberdotierte Germaniumsulfid-Ätzmaske. An den folgenden Strukurierungsprozeß gibt es zwei Anforderungen:
Das Verhältnis der Ätzrate des Substrates zu der der Ätzmaske wird als Selektivität des Ätzprozesses bezeichnet. Bei der Herstellung von Zonenplatten müssen relativ dicke Substratschichten von einigen hundert Nanometern mit relativ feinen Strukturen von einigen zehn Nanometern versehen werden. Das Verhältnis von Strukturhöhe zu Strukturbreite wird als Aspekt-Verhältnis bezeichnet. Die Tabelle gibt die Parameter von einigen Substratmaterialien für die Herstellung der Göttinger Mikrozonenplatte 3 (MZP3) wieder. Der maximale Beugungswirkungsgrad EMax(englisch: efficiency) gibt an, wieviel Prozent der auf die Zonenplatte auftreffenden Strahlung
Material EMax [%] Sopt [nm] Aspektverhältnis Ni 24.2 252 4.6 Si 22.9 630 11.5 C 20.2 376 6.8 Ge 20.0 401 7.3 Au 12.0 184 3.3
in den Fokus der ersten Beugungsordnung fällt. Die optimale
Schichtdicke Sopt gibt den Wert der Schichtdicke des Materials
an, bei der der maximale Beugungswirkungsgrad der MZP3 erreicht wird. Die äußeren,
feinsten Strukturen der MZP3 haben eine Breite von 55 nm. Hieraus
folgt das angegebene Aspektverhältnis in Spalte 4 der Tabelle.
Näheres zu den Zonenplatten findet sich in
xray1, thieme, hilkenbach.
Die meisten Resistmasken sind nicht stabil genug, um dicke Substrate
fein genug zu strukturieren. Daher werden unter der Resistschicht
eine oder mehrere Zwischenschichten aufgebracht, die im
Mehrschichtprozeß strukturiert werden und als Ätzmasken dienen. Dreischichtverfahren zur Herstellung von MZP3 primäre Struktur mittels UV-Holographie in einen organischen
Photoresist (AZ 1350 SF) übertragen. Diese Resistmaske dient dazu,
eine sehr dünne Titanschicht von ca. 10 nm mittels reaktiver Ionenätzung im Bortrichlorid-Plasma zu
strukturieren. Die Titanschicht ist sehr stabil gegen ein reaktives Sauerstoff-Plasma und dient als Maske
zur Strukturierung einer 120 nm dicken Kunststoffschicht (Polyimid
oder PIQ). Diese endgültige Ätzmaske ist nun wiederum
stabil gegen ein Plasma von halogenierten Kohlenwasserstoffen, mit
dem das 380 nm dicke Germaniumsubstrat
nm geätzt wird. Die Germaniumschicht ist auf einer PIQ-Trägerfolie
aufgebracht und von dieser mit einer 5 nm dicken Chromschicht
getrennt. Die Chromschicht dient als Haftvermittler und als Ätzstop
zum Schutz der Trägerfolie. Als Substrat dient ein Glasträger, der
nach der Strukturierung mit Flußsäure entfernt wird. Es verbleibt
die Germaniumstruktur auf der Folie.
Das Mehrschichtverfahren umgeht zum einen die geringe Ätzselektivität
zwischen dem organischen Resist und der Germaniumschicht, zum anderen fördern die relativ dicken
Zwischenschichten das anisotrope Ätzen im Plasma. Da
naß-chemische Ätzmittel isotrope Medien isotrop ätzen, lassen sich
mit diesen keine steilen Strukturen mit hohen Aspektverhältnissen
und kleinen Strukurbreiten realisieren. Mit der beschriebenen RIE-Anlage wurden Untersuchungen zum Ätzverhalten von
GeS2-Schichten unternommen. Es wurden HCM-Substrate mit
GeS2-Schichten mit Dicken < 50 nm beschichtet (nach
Abschnitt). Die Schichten wurden sensibilisiert und mit einer
Blende auf der halben Fläche mittels Kaltlichtlampe belichtet.
Danach wurden die Schichten desensibilisiert.
Die eine Hälfte der Schicht war somit silberdotiert, die andere
nicht. Durch Auflegen einer massiven Ätzmaske (HCM-Deckglas) im
RIE-Reaktor konnten Stufen in die Schicht geätzt werden. Durch
Ausmessen der Stufen mit einem Talystep-Profilometer konnten die
Ätzraten bei unterschiedlichen Ätzparametern bestimmt werden. Als
Parameter wurden das Ätzgas, der Ätzgasdruck und die eingestrahlte
Hochfrequenzleistung, d.h. die sich einstellende Selfbias-Spannung variiert.
In den Abbildungen sind die
Resultate wiedergegeben. RIE-Kurven von GeS2-Schichten im Argon-Plasma RIE-Kurven von GeS2-Schichten im Sauerstoff-Plasma RIE-Kurven von GeS2-Schichten im Wasserstoff-Plasma RIE-Kurven von GeS2-Schichten im Bortrichlorid-Plasma RIE-Versuche mit SF6 und CBrF3 als Ätzgasen führten
selbst bei minimierten Ätzparametern bzgl. eingestrahlter Leistung
und Ätzgasdruck zu sehr hohen Ätzraten, die
deren Anwendung zur Strukturierung kaum zulassen (siehe Tabelle). Bei allen Ätzgasen ließ sich kaum ein Unterschied zwischen den
Ätzraten der dotierten und undotierten Bereiche feststellen. Beim
CBrF3 ergab sich eine sehr geringe Selektivität von 1.4:1. Die sehr
geringe Selektivität kann durch einen zu geringen Dotierungsgrad
bedingt sein, denn bei der RIE mit halogenierten Ätzgasen wäre die Bildung einer Passivierungsschicht
von nichtflüchtigen passiven Silberhalogenidschichten zu erwarten gewesen
vadimsky1,
hugett1.
Das bedeutet, daß sich mit sehr dünnen Germaniumsulfidschichten
dicke Polymerschichten strukturieren lassen. Polymer- und
Kohlenstoffschichten sind in der Regel stabiler gegen halogenhaltige
Ätzplasmen als das Germaniumsulfid.
Zur Strukturierung von Germaniumschichten bietet sich ein CBrF3-
Plasma in Verbindung mit einer amorphen Kohlenstoffmaske an.
Aufgrund der Ätzraten der Einzelkomponenten läßt sich hierbei eine
Selektivität von ca. 10 erwarten. D.h:, daß zur Strukturierung einer
400 nm dicken Germaniumschicht, wie sie für MZP 3 als
Phasenzonenplatte gebraucht werden, im CBrF3-Plasma eine 40 nm dicke
amorphe Kohlenstoffschicht ausreicht. Zur Strukturierung dieser
C-schicht würde eine ( nm dicke Germaniumsulfidschicht im
auerstoffplasma ausreichen. Versuche hierzu begannen nach Vollendung
dieser Arbeit.Mehrschichtverfahren
In der Mikrolithographie werden Mehrschichtsysteme häufig verwendet.
In der Literatur werden einige Anwendungen vom GexSe(1-x)-Resistsystem
in Mehrschichtsystemen erwähnt hugett2,
lis,
tai2,
lamey.
Zur Herstellung der feinen
MZP3-Strukturen wird derzeit ein Dreischichtverfahren angewandt.
Dabei handelt es sich um ein abgewandeltes Verfahren nach tennant.
Die Abbildung zeigt den Aufbau des Systems. Bei diesem wird die 
Trockenätzverhalten von GeS2-Schichten
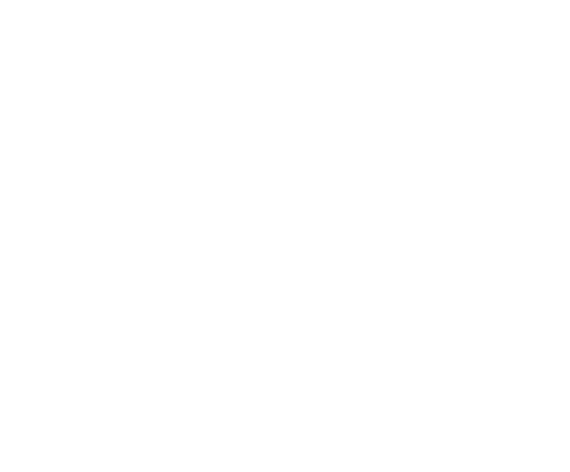
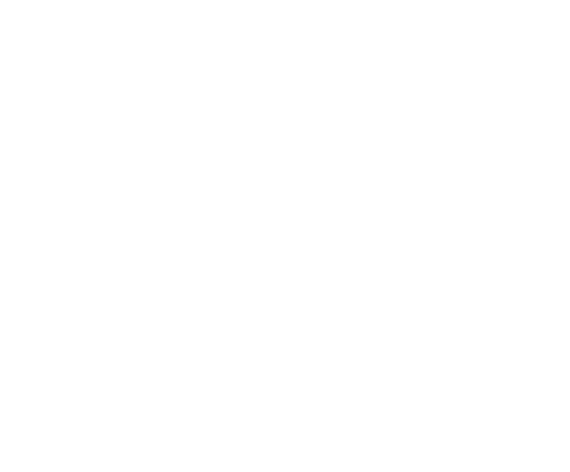
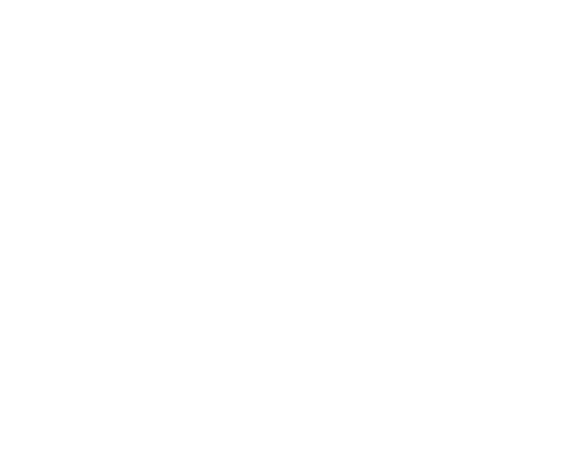

Ätzgas Gasdruck [Pa] USelfbias [V] Ätzrate [nm/min] CBrF3 0.9 40 ca. 30 SF6 0.9 40 ca. 60
Aufgrund der Stabilität der Germaniumsulfidschichten gegenüber
einem reaktiven Sauerstoffplasma bietet sich die Verwendung von
GeSx-Schichten zur Strukturierung von im O2-Plasma
strukturierbaren Schichten an. Organische Schichten wie die
Polymerschichten Polyimid und PIQ, wie auch aufgesputterte amorphe
Kohlenstoffschichten lassen sich gut im Sauerstoffplasma reaktiv ätzen. Aus
eigenen RIE-Untersuchungen zum Ätzverhalten von amorphen
Kohlenstoffschichten folgt eine ca. 5 mal größere Ätzrate
(Selektivität=5) im O2-Plasma als die des Sulfids (bei
einem Sauerstoffdruck von 1.33 - 4 Pa und einer Leistungsdichte von
0.5 W/cm2). Aus Untersuchungen zum reaktiven Ätzen von PIQ und
Polyimid von Husemann
ergibt sich bei einer Selfbiasspannung
von 0.4 kV und 1.33 Pa Gasdruck eine Selektivität von 38 bzw. bei
einem Gasdruck von 6.66 Pa und gleicher Selfbiasspannung eine
Selektivität von 68 gegen Germaniumsulfid (siehe
Tab.).
Die Daten zum PIQ/Polyimid und Ge
sind aus Husemann und für eine Selfbiasspannung von 400 V.
Die Daten zum amorphen Kohlenstoff sind in Zusammenarbeit mit Dr. G.Danev
vom Zentrallabor für Photographische Prozesse ermittelt wordenÄtzgas Gasdruck [Pa] Ätzrate [nm/min] für GeSx Ätzrate [nm/min] für C(amorph) Selektivität O2 1.33 1.58 ca. 6 ca. 4 O2 2 1.59 7.6 4.8 O2 2.66 1.59 8.1 5.1 O2 4 ca. 1.72 8.4 ca. 4.9
Ätzgas Gasdruck [Pa] Ätzrate [nm/min] für C(amorph) Ätzrate [nm/min] für Ge Selektivität CF4 1.33 ca. 10 28.3 ca. 3 SF6 1.33 140 426 ca. 3 SBrF3 1.33 11.1 118 ca. 10 Ar 6.66 9.2 17.3 ca. 2
Ätzgas Gasdruck [Pa] Ätzrate [nm/min] für PIQ/Polyimid Ätzrate [nm/min] für GeSx Selektivität O2 1.33 57 ca. 1.5 ca. 38 O2 6.66 137 ca. 2 ca. 68