
Röntgenmikroskopie wird mit weicher Röntgenstrahlung im Wellenlängenbereich von 2 bis 5 nm betrieben. Da sich der Brechungsindex aller Stoffe für Röntgenstrahlung nur sehr wenig von eins unterscheidet, sind Brechungsoptiken in diesem Bereich nicht möglich. Als Optiken in diesem Bereich sind Spiegeloptiken (Spiegel im streifenden Einfall sowie Mehrschichtspiegel für größere Einfallswinkel) und Beugungsoptiken möglich. Beugungsoptiken sind Beugungsgitter, die durch die Anordnung der Gitterlinien oder durch die Form des Substrates, auf dem sie aufgebracht sind, oder durch Kombination von beiden, neben dispergierenden auch abbildende Eigenschaften aufweisen. Eine Übersicht über Röntgenoptiken für den genannten Strahlungsbereich findet sich in Schmahl. Eine spezielle Form von Beugungsoptiken sind Zonenplatten; dies sind rotationssymetrische Beugungsgitter mit nach aussen abnehmender Gitterkonstanten. Zonenplatten werden in der Röntgenmikroskopie als hochauflösende Mikroobjektive mit Durchmessern von 0.02 - 0.1 mm, einigen hundert Zonen und äußeren Zonenbreiten von derzeit 30 nm verwendet. Das Auflösungsvermögen der Zonenplatten entspricht der Breite der äußeren Zone. Für eine höhere Auflösung werden entsprechend Zonenplatten mit noch geringeren äußeren Zonenbreiten -- bis etwa 10 nm -- angestrebt. Als Kondensoren werden Zonenplatten mit 2 bis 9 mm Durchmesser mit bis zu 40000 Zonen und äußeren Zonenbreiten von 50 nm benutzt. Ausführliche Darstellungen über Zonenplatten finden sich in eformierter Kugelwellen erzeugt. Ein weiteres Verfahren besteht darin, die Strukturen mit Hilfe eines Elektronenstrahls zu schreiben bogli. In beiden Fällen wird die ZP-Struktur im ersten Schritt in einem geeigneten licht-bzw. elektronenempfindlichen Material erzeugt bzw. fixiert. Diese Materialien werden Photoresists genannt. Sie dienen im allgemeinen im zweiten Schritt als Ätzmasken für die Übertragung der Strukturen in darunterliegende Schichten.
In der Praxis werden zur Zeit - auch in der industriellen Produktion von Mikrostrukturen - organische Photoresists verwendet. Diese organischen Photoresists bestehen aus hochmolekularen organischen Kettenmolekülen (Polymeren), die bei Belichtung mit geeigneter Strahlung ihre Struktur ändern. Man unterscheidet grundsätzlich zwei Typen: Zum einen die positiven Photoresists, bei denen sich bestrahlte Bereiche durch geeignete Entwicklungsverfahren entfernen lassen. Hierbei bleiben die unbestrahlten Resistbereiche erhalten und dienen im zweiten Schritt als Ätzmaske. Positive organische Photoresists werden derzeit zum Bau von holographischen ZP verwendet. Zum anderen gibt es die negativen Photoresists. Bei diesen werden die bestrahlten Resistbereiche fixiert und die unbelichteten Bereiche beim Entwickeln entfernt, so daß eine negative Maske entsteht. Die Auflösung der organischen Photoresists ist begrenzt auf die Größe der organischen Kettenmoleküle, die im Bereich zwischen 10 und 100 nm liegt. Ein weiterer auflösungsbegrenzender Effekt liegt in der hochmolekularen 3-dimensionalen Netzstruktur. Bei der Entwicklung dringt das Entwicklermedium in den elastischen Polymer ein und bringt diesen zum Aufquellen.
Als anorganische Photoresists bezeichnet
man im allgemeinen Materialien, die aus amorphen oder kristallinen anorganischen
Verbindungen bestehen und die durch Bestrahlung ihre chemisch-physikalische
Konstitution so ändern, daß sich Strukturen in diese Materialien
übertragen lassen. Es gibt verschiedene Klassen von anorganischen
Photoresists (AR). Wenn in dieser Arbeit von AR gesprochen wird, handelt
es sich um Resists, die auf amorphen Chalkogeniden basieren. Bei den Chalkogeniden
handelt es sich um Verbindungen mit Elementen der 6.Hauptgruppe des Periodensystems
der Elemente. Erste Versuche an amorphen Chalkogenidschichten unternahm
1966 Kostyshin in der Sowjetunion kostyshin.
Er untersuchte As2S3 und As2Se3
in Verbindung mit Silbersubstraten als AR. Kostyshin sagte ihnen, wie auch
CuJ, CuCl, SbJ3, SbS3, CdS, ein hohes Auflösungsvermögen
im Bereich einiger zehn Nanometer und Anwendungen in der Mikrolithographie
voraus. Auf größer werdendes Interesse stießen die AR
gegen Ende der 70er/ Anfang der 80er Jahre, da die AR dank ihrer amorphen
anorganischen Struktur ein hohes Auflösungsvermögen versprechen.
Bis heute sind speziell GexSe(1-x) und As2S3
von wissenschaftlichem Interesse; in der industriellen Anwendung dagegen,
werden sie praktisch noch nicht verwendet. In dieser Arbeit wird GeSx
als Basis für ein Photoresistsystem untersucht. Da in der Literatur
GeSx als AR noch nicht zu finden ist, werden hier analoge Untersuchungen
zum GexSe(1-x) - Resistsystem aufgeführt. Da
GeSx und GexSe(1-x) chemisch nah verwandt
sind und beide Verbindungen Photoresistverhalten zeigen, wie in meiner
vorangegangenen Diplomarbeit xx
gezeigt werden konnte, liegt es nahe, Phänomene des GexSe(1-x)-Systems
auf das GeSx-System ohne weitere Einschränkungen zu übertragen.
Um Chalkogenide als AR in der Mikrolithographie nutzen zu können,
gilt es diese als dünne Schichten auf geeignete Trägermaterialien
aufzubringen. Das zumeist angewandte Verfahren ist die Bedampfung des Trägers
(Substrat) im Vakuum. Das Chalkogenid wird meist thermisch oder mit dem
Elektronenstrahlverfahren verdampft. Der Strom der aus dem erwärmten
Chalkogenid austretenden Atom- bzw. Moleküleinheiten kondensiert auf
dem Trägermaterial. Beim Kondensieren tritt ein Abschattungseffekt
auf, der eine für das Resistverhalten wesentliche innere Struktur
ergibt. Einmal kondensierte Atom- bzw. Moleküleinheiten lassen sich
nur noch in geringem Umfang vom Ort ihres ersten Auftreffens verdrängen
und schatten dadurch Bereiche jenseits der Aufdampfquelle von weiterer
Kondensation ab (siehe Abb. Modell zum Säulenwachstum).
Es entsteht eine Säulenstruktur in dem sich bildenden amorphen Film.
Diese Säulenstruktur hat ein anisotropes Ätzverhalten zur
Folge. Zur Entstehung dieser Sülenstruktur haben Dirks
und Leamy Modellrechnungen angestellt. Die Abschattung führt selbst
bei senkrechter Lage des Substrates zum Atom- bzw. Molekülstrom zu
Säulenstrukturen, die durch relativ große Leerstrukturen voneinander
getrennt sind. Bei schräg zum Atom- bzw. Molekülstrom positionierten
Substraten sind diese Leerstrukturen erheblich größer. Dirks
und Leamy betrachteten die Atom- bzw. Moleküleinheiten als harte Scheiben,
d.h. die Einheiten lassen sich nicht deformieren und nicht vom Ort ihres
ersten Auftreffens verdrängen. Bei der Verdampfung von GeSx
treten in der Dampfphase größere Verbände von GeS2
mit S, z.B. Ge6S12(S1/2)2 auf,
welche bei der Kondensation, die leichteren Schwefelatome oder Schwefelringe
in die Leerstrukturen drängen (in Analogie zu der GexSe(1-x)-Verdampfung
in der Arbeit von Phillips).
Daraus folgt, daß die Säulen aus einer Germanium-angereicherten
und die Leerstrukturen aus einer Schwefel-angereicherten Phase bestehen
(in Analogie zu phillips2).
In einer Untersuchung mit Röntgenstreuung an 7 µm dicken, lotgerecht
zum Substrat aufgedampften reinen Germaniumschichten ergaben sich Leerstrukturen
mit Ausmaßen von 2.2 und 4.6 nm in der Filmebene und 220 nm senkrecht
dazu, wobei der Volumenanteil der Leerstrukturen bei diesen Filmen ca.
1 - 2 % betrug cargill.
Streuversuche mit Neutronen ergaben, mit dem Modell von ellipsoidalen Leerstrukturen,
Größenordnungen von 24 nm in Säulenrichtung und ca. 12
nm senkrecht dazu rayment.
Allgemein gilt, daß die Säulen nicht genau in Richtung der Aufdampfquelle
wachsen . Dies läßt sich geometrisch mit einem zweidimensionalen
Modell aus harten Scheiben veranschaulichen dirks.

Abb.: Modell zum Säulenwachstum
Im senkrechten Einfall der Atome (siehe Abb. Modell
zum Säulenwachstum a) besitzt jede Scheibe, entsprechend den Atom-
bzw. Moleküleinheiten, eine Einfanglänge l (im zweidimensionalen
Fall) von 4r, wobei r dem Scheibenradius entspricht. Im schrägen Einfall
der Atome (Einfallswinkel alpha) ist diese Einfanglänge nun geringer
als 4r, da sie durch die schon existierende Filmebene einseitig begrenzt
wird. Die Mitte dieser Einfangzone, d.h. die Säulenhauptwachstumsrichtung
(Winkel ß), ist zur Senkrechten verschoben (siehe Abb. Modell
zum Säulenwachstum b). Aus diesen Überlegungen folgt die
experimentell bestätigte Tangentenregel:
![]()
Durch Bestrahlung mit hohen Dosen werden
Bindungen im Chalkogenid aufgebrochen, die Säulenstruktur bricht zusammen
und die Schichtdicke verringert sich durch das Auffüllen der Leerstrukturen
rayment. Dieses gilt besonders
für Filme, die schräg aufgedampft wurden, da hier der Leerstrukturanteil
erheblich größer ist als bei den Filmen, die senkrecht zur Substratebene
aufgedampft wurden. Durch das Zusammenbrechen der Säulen ändert
sich die Löslichkeit gegenüber unbestrahlten Stellen, da die
Angriffsfläche für das Lösungsmittel verringert wird. Damit
lassen sich die belichteten Strukturen durch chemische Entwicklungsverfahren
entwickeln. Bei Bestrahlung mit Photonen ( Quecksilberdampflampe ) werden
Dosen von bis zu 1200 J/cm2 benötigt, um Kontraktionen
der Ge.25Se.75-Schichten von 12 % bei einem Aufdampfwinkel
von 80o zu erreichen singh1.
Bei Bestrahlung mit 50 keV He+ Ionen wurden Kontraktionen von
bis zu 39 % gemessen. Bei Bestrahlung mit 8 keV Elektronen folgten Kontraktionen
von 29 %, bzw. 26 % für unter 75o Winkel zur Senkrechten
aufgedampfte GeSe2-Filme, die mit 1 MeV He+-Ionen
beschossen wurden chopra1,venkatesan.
In dieser Arbeit wurden keine Untersuchungen bezüglich der silberlosen
Verwendung von GexSe(1-x) -Schichten gemacht, da
die benötigten Dosen von 1200 J/cm2 Belichtungszeiten von
Stunden entsprechen würden.
Silberhaltige Photoresists zeichnen sich gegenüber den silberlosen AR durch eine 2000 fach höhere Sensibilität aus. Zur Sensibilisierung wird der amorphe Chalkogenidfilm mit einer Silberschicht bedeckt. Eine ähnliche Sensibilisierung läßt sich auch mit anderen Metallen, z.B. Cu oder Sn, erreichen. Silber wird wegen seiner hohen atomaren und ionischen Mobilität im Chalkogenid bevorzugt verwendet phillips3. Die Silberschicht wird in der Regel durch einen stromlosen, oberflächlichen, galvanischen Überzug erzeugt, der durch Eintauchen der Chalkogenidschicht in eine Silbersalzlösung entsteht. So bildet sich auf GexSe(1-x) bzw. As2Se3 ein poly- kristalliner Film aus Ag2Se. Auf GeSx bzw. GexSe(1-x) bildet sich entsprechend ein polykristalliner Film aus Ag2S. Durch den Metallchalkogenidüberzug wird aus dem vorher uniformen halbleitenden Chalkogenidglas ein System Metallchalkogenid - Halbleiter. In einer Arbeit von Kluge wird die Bänderstruktur der Elektronenzustände bei diesem Übergang mit dem des Schottky-Kontaktes angenähert kluge.
Die Bandstruktur des Chalkogenides
wird durch den Metall(sulfid)kontakt aufgrund der Angleichung der Ferminiveaus
des Metalls und des Chalkogenids verbogen. In der Abbildung
zeigt dies Modell wobei EF die Lage der Fermienergie angibt,
EV bzw. EL die Energiekanten des Valenz- bzw. Leitungsbandes
des Chalkogenids bezeichnet. In der Arbeit von Kluge
werden zwei Mechanismen zur Erklärung der Dotierung vorgeschlagen
(siehe Abbildung):

Modelle zur photostimulierten Dotierung
a)
b)
Mit längerer Belichtung tritt Silber immer tiefer und gleichmässiger
in den darunter liegenden Chalkogenidfilm ein wagner.
Tai et al. machen in ihrer Arbeit folgenden Ansatz zur Ag-Diffusion tai1,
den ich hier direkt auf das GeSx-System übertrage. Seien C(x,t)GeSx
bzw. C(x,t)Ag2S die lokalen, zeitlichen Volumenkonzentrationen
des Silbers im Chalkogenid bzw. der silberhaltigen Schicht. Sei I(x) die
lokale Bestrahlungsintensität und K ein Proportionalitätsfaktor.
Es sei die zeitliche Änderung der Silberkonzentration im Chalkogenid
proportional zur Bestrahlungsintensität und proportional zur Silberkonzentration
in der Silbersulfidschicht:

mit:

Hieraus läßt sich das Optimum der Ag2S-Schichtdicke bestimmen, welche ein großes Reservoir an Silber, aber auch eine geringe Absorption an wirksamen Licht, miteinander vereint. Es folgt aus:

1-a'C(x,t)Ag2S=0 und schließlich T=1/a als optimale Schichtdicke. Durch die Diffusion des Silbers in die Säulen- und Leerstrukturen des AR werden diese gegen physikalisch-chemische bzw. chemische Ätzverfahren resistenter, also entwickelbar.
Wie erläutert
besitzen Ag-Atome und Ag+-Ionen im polykristallinen Ag2S
eine hohe Mobilität. Durch lokale Bestrahlung des Silber/Chalkogenidfilmsystems
und der damit einhergehenden Ag-Dotierung des Chalkogenids verarmt die
silberhaltige Schicht an Silber. Somit kommt es in der
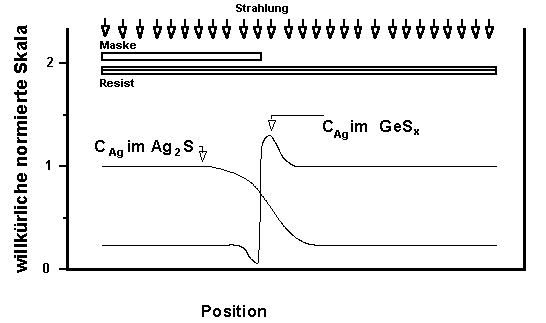
Modell zum Dotierungsprofil
Ag2S-Schicht zu einem Silberkonzentrationsgefälle zwischen bestrahlten und unbestrahlten Bereichen (siehe Profile in der Abbildung ong1). Dies Konzentrationsgefälle bewirkt eine seitliche Diffusion von Silberatomen in der Silbersulfidschicht aus den unbestrahlten Bereichen in die bestrahlten Bereiche. Dies führt zur Konzentrationsnivellierung. Bei der lateralen Diffusion der Silberatome innerhalb der Silbersulfidschicht von den unbestrahlten in die bestrahlten Bereiche kommt es beim Übergang in die bestrahlten Bereiche zur strahlungsinduzierten Diffusion in die Tiefe des Chalkogenids. Das Silber diffundiert als Ag+ in den Chalkogenidfilm. Damit ist die Ag-Dotierung an den Rändern, d.h. in den Grenzregionen von bestrahlten und unbestrahlten Regionen verstärkt und deren Fixierung, d.h. deren Ätzresistenz, vergrößert (siehe das Profil in der Abbildung ong1). Dieser Effekt bewirkt eine Kontrastverstärkung.
Zu Beginn der Bestrahlung besitzt die Silbersulfidschicht überall die gleiche Schichtdicke und Ag-Konzentration. Durch die Bestrahlung verarmen die bestrahlten Bereiche dieser Schicht an Silber. Dies führt dazu, daß sich die Absorption dieser Schicht entsprechend verringert. Dadurch kann immer mehr Strahlung bis zur Grenzschicht, in der die Silberdotierung stattfindet, vordringen. Die silberhaltige Schicht bleicht somit aus. Dieses Ausbleichen verstärkt aber gleichzeitig die Tiefendiffusion des Silbers in die amorphe Chalkogenidschicht. Dies erhöht wiederum Ätzresistenz und Kontrast tada, janossy.
Aufgrund der phasenseparierten Säulenstruktur
und der Diffusion von Silber in diese Säulen werden diese Strukturen
dem Angriff durch den Entwickler entzogen bzw. deren Resistenz vergrößert
ong1. Die Silberatome dienen
so als Ätzmaske im Entwicklungsprozeß.

Modell zur phasenseparierten Säulenstruktur und zur Erläuterung des anisotropen Ätzens
Das Ätzmittel kann in den undotierten, ungeschützten Bereichen in die Leerstrukturen eindringen und die Säulenstruktur von allen Seiten angreifen, was in den dotierten, geschützten Bereichen durch die chemische Resistenz des Silbers nicht in gleichem Maße stattfinden kann ong1. Damit werden das zumeist unerwünschte Unterätzen bzw. das Überätzen reduziert. Es entstehen senkrechte Ätzprofile.
Durch die im Vergleich zu den organischen Photoresists erhöhte Maskenstabilität der entwickelten AR-Schicht reichen geringe AR-Schichtdicken von d<100 nm aus, um als Ätzmasken dienen zu können. Desweiteren ist die Transparenz des Chalkogenides, besonders im UV-Bereich, gering. Daher kann es bei der Belichtung nicht zur Ausbildung von stehenden Wellen im Resist kommen. Diese stehenden Wellen haben in den organischen Photoresists inhomogene Belichtungen in der Tiefe zur Folge. Dies führt zu unsauberen Ätzprofilen.
Untersuchungen der Silberdotierung mit feinen Silberpartikeln, die in einer Argonatmosphäre von 666 Pa Gasdruck aufgedampft wurden, haben ergeben, daß der Ge-Se-Photoresist ein Auflösungsvermögen von ca. 1 nm besitzt. Dies entspricht der Größe der atomaren bzw. molekularen Einheiten im Chalkogenid yoshikawa1. Mit Elektronenstrahlen wurden schon Linien mit Breiten von 50 nm in Ag2Se:Ge0.1Se0.9 gezogen und chemisch entwickelt singh2.
Der Resist-Kontrast ist als die Steigung
der Kurve - verbleibende normierte Resistschichtdicke als Funktion des
dekadischen Logarithmus der Bestrahlungsdosis - definiert
polasko1(siehe
Abb. ):
![]()
wobei Do die Dosis ist, bei der erste Veränderungen des
Resists aufgrund der Bestrahlung bemerkbar sind, d.h. seine normierte Dicke
nach der Entwicklung gerade noch Null ist. D1 ist die minimale Dosis, bei
der der Resist nach dem Entwickeln vollständig erhalten bleibt, d.h.
seine normierte Dicke 1 bleibt.
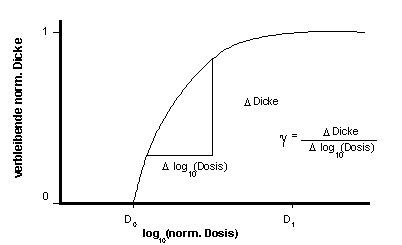
Zur Definition des Resistkontrastes
Graphisch läßt sich der Kontrast als Steigung des linearen Bereiches
im Diagramm: normierte verbleibende Resistschichtdicke als Funktion des
dekadischen Logarihmus der Bestrahlungsdosis darstellen polasko1.Der
Resistkontrast ist, unter anderem, sehr vom Entwicklungsprozeß abhängig.
Die Selektivität eines Entwicklungsprozesses ist das Verhältnis
der Ätzrate der unfixierten Bereiche zu der der fixierten Bereiche
des Resists.
Untersuchungen am GexSe(1-x)-Resistsystem
lassen eine hohe Strahlungsempfindlichkeit erwarten. Die Empfindlichkeitsangaben
variieren sehr stark. Die Belichtung wie auch der Entwicklungsprozeß
haben einen großen Einfluß auf diese Resisteigenschaft. Die
Tabelle zeigt eine Übersicht zum Ag2Se:GexSe(1-x)-System.
Literaturübersicht zum GexSe(1-x)-Resist
Ätzverfahren Resistkontrast Selektivität Empfindlichkeit [mJ/cm2] SF6-RIE 7-8 500:1 40-50 CF4-Tonnen-Plasma-Ätzen 4 390:1 90 naß-chemisch 4 20:1 200-700
naß-chemisch
5.2 (UV-Eximerlaser-Belichtung) naß-chemisch (x=.33) ~15 000 naß-chemisch (x=.2) ~400